Előadás nanolithography - Mr. Stefanovic
Előadás témája: „” nanolithography „Stefanovic GB egyik legfontosabb folyamatokat mikroelektronika több mint 40 éve továbbra is litográfia.” - átirata:
1 "nanolithography" Stefanovic GB

2. Az egyik meghatározó folyamatok mikroelektronika több mint 40 éve továbbra is litográfia. Litográfia vagy mikrolitográfiás, de most megfelelő lehet beszélni nanolithography, célja, hogy hozzon létre egy topológiai alakja a felületén monokristályos szilícium ostya. Alapvető litográfiai eljárás a modern mikroelektronika van fotolitográfiában.

Március 10. szakaszában a litográfiai eljárás. 1. Felület-előkészítés (mosás és szárítás) 2. alkalmazása a reziszt (polimer vékony film rakódik centrifugálással) 3. szárítással (oldószer eltávolítása és átadása a ellenállni oldható szilárd fázisú) 4. Kombinált fotomaszk és az expozíció (pozitív ellenállni fénynek van kitéve válik oldhatatlan fázis ) 5. a megnyilvánulása a reziszt (mosás egy oldószerben, távolítsa megvilágítatlan ellenállni)
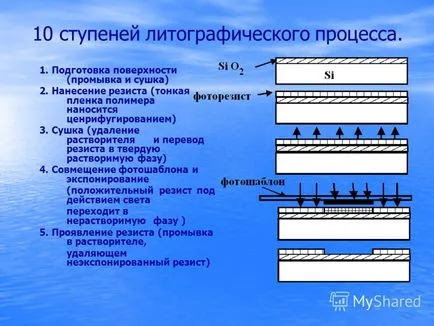
4 6. Stabilizáló lágyítás (a maradék oldószer eltávolítása) 7. A szabályozás és korrekciója hibák. 8. Pácolás (közvetlen maszk mintát át a felszínre a félvezető szerkezet) 9. eltávolítása fotoreziszt finiser kontroll.

5 A használata optikai litográfia előállítására szerkezetet nanométeres skálán. A minimális méret minta, amely lehet megoldani változtatásával az optikai rendszer segítségével becsülhető egy ismert formula a termelés chipek 350 nm 360 nm minták használt ív higanylámpával (i vonal). További növekedése az integráció mértéke chipek vezetett az átmenet a litográfiai rendszerek területén az úgynevezett mély ultraibolya (UV mély). 250 nm tranzisztorok húzunk 248 nm KrF excimer lézer 180 nm-es sugárzás litográfiai működik 198 nm ArF excimer lézert. Future nm litográfiai középpontjában a használata 157 nm F2 lézer.

6 fáziseltolással maszk. a) sablon nélkül fáziseltolás. b) mintát egy fáziseltolódás.

7 alternatív EXPOZÍCIÓ. A szerkezetek felbontása kisebb, mint 100 nm-nél válik indokolttá az innovatív módszerek az expozíció. Figyelembe véve, hogy szükség van ahhoz, hogy magas teljesítményű litográfiai rendszerek a következő 4 fő területen: korlátozó vagy EUV (extrém UV litográfia - EUVL), elektron vetítési litográfia (szike segítségével), X-ray litográfiai (X-ray litográfia), ion litográfia (ionsugaras litográfia) .
8 extrém ultraibolya litográfia. EUVL van hagyományos optikai litográfia, de a besugárzás alkalmazása a hullámhossz nm és a fényvisszaverő optika, és fotómaszkok. EUVL sugárforrások az első fejlődési szakaszban az ilyen rendszerek a szinkrotron sugárzás. Később azonban úgy tervezték, kompakt UV teljesítmény korlát, a működési elve azon alapul, a sugárzás egy lézer-plazma. Kibocsátási szabvány Nd: YAG lézer (1063 nm-es hullámhosszon, teljesítmény 40 W, 100 Hz frekvenciájú, időtartama 5 ns) középpontjában egy pulzáló gázsugár Xe klaszterek.
9. reakcióvázlaton EUV litográfia.
Rendszer 10 EUV litográfiai maszkok.
11 vetítési elektron-litográfia. KORLÁTOZÁSOK vetítési EBL: fűtés 1.Termichesky maszk. 2. a nagy numerikus apertúra. Megértése a korlátozások az adszorpciós EBL ez vezetett az új EBL vetítőrendszereknél amelyek közül az egyik hívták szikével. A fő különbség az új rendszer a korábbi, hogy egy új típusú maszkokat. SZIKE maszk rendszer egy sor membránok készült könnyű elemek nagy permeabilitású az elektronok. Ábra filmek létrehozott nehéz elemek magas visszaverő.
12. Alapelv SZIKE rendszer:
13, elektronok áthalad a membránon vannak szétszórva a kis szögek, mivel ábra szóródik elektronok nagy szög. A nyílás található, a hátsó fókuszsíkjában optikai mező rendszer bejut elektronok szétszórt kis szögek, és átadja elektronok szórt nagy szög, amely ahhoz vezet, hogy a kialakulását a nagy kontrasztú képeket a szubsztrát. Ebben az esetben, egy maszk nem jelentős felszívódását az elektronsugár, amely minimalizálja a termikus instabilitása a maszk.
14
15
16
OPTICS 17 Érzékenység = 1060 nm 1 mJ / SM2 = 560 nm-en 0,5 mJ / SM2 = 118 nm 16 mJ / SM2 EL EXPOZÍCIÓ U = 50 kV 15 C / SM2 5 U = 10 kV Cl / SM2 ENABLE kisebb, mint 100 nm-EL . U = 50 kV, és a dózist a C / SM2 KEY ellenállni PARAMÉTEREK
A szubmikron méretű 18 vonalak kialakítva a Si metodomi elektronsugaras litográfia és plasmochemical maratásnak az ellenállni vanádium-oxid.